Blog
Intel Foundry Nears Major Customer Wins as Apple, AMD, Google, and NVIDIA Weigh Deals
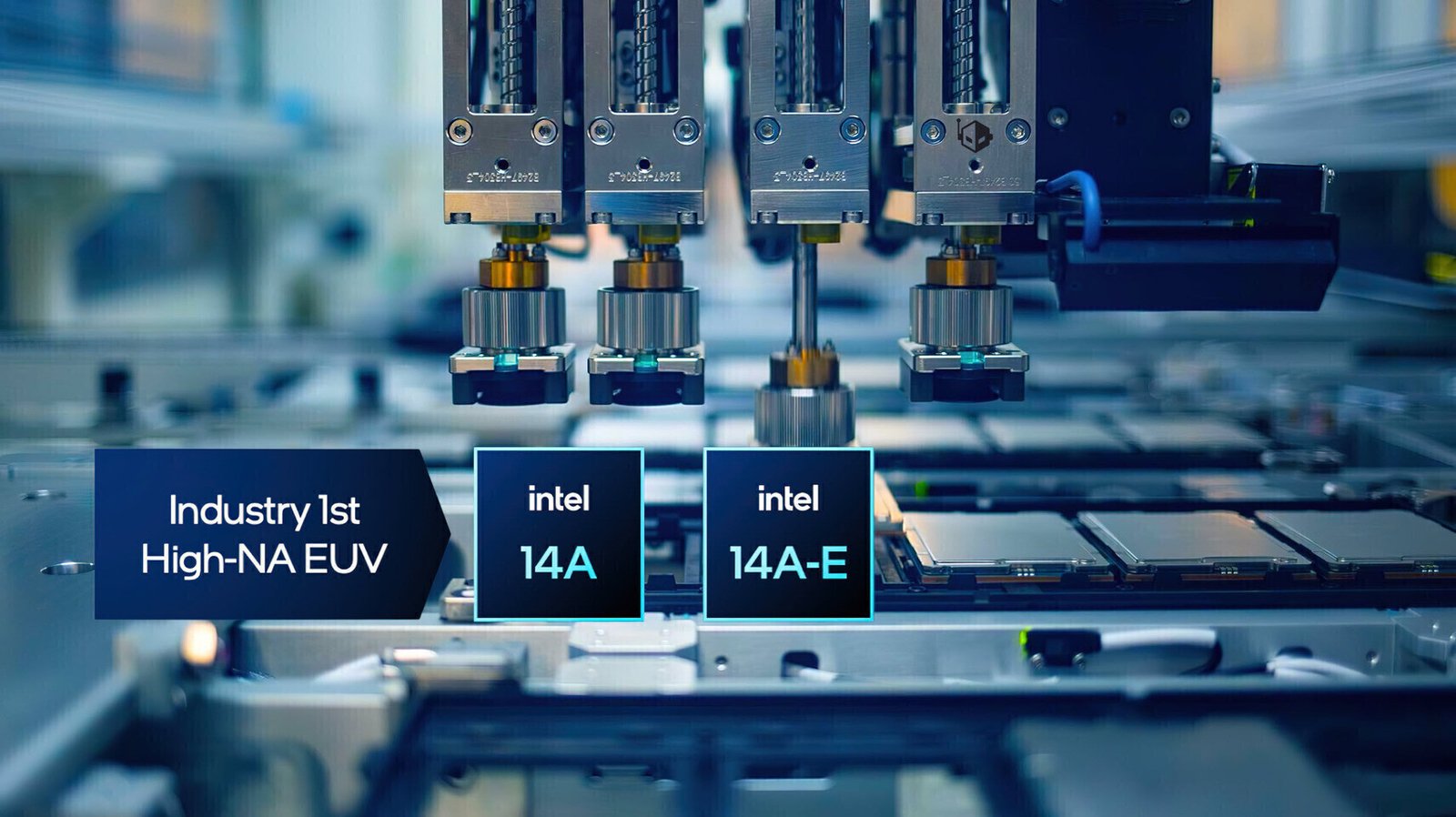
Companies regularly evaluate leading industry nodes but often choose TSMC’s manufacturing due to its reliability, high volume capacity, and advanced packaging, which has produced numerous high-performance and low-power designs at scale. However, Intel Foundry has been investing significant resources and logistics into attracting external clients, leading UBS to anticipate multiple foundry commitments being announced this fall. Late last year, we learned that Apple was waiting for Intel to release the 18A-P PDK version 1.0 or 1.1, scheduled for Q1 and Q2 of 2026, respectively. As we are now in Q2, we are awaiting further confirmation to see if Apple proceeded with the deal, but UBS expects it did.
Another significant opportunity for Intel Foundry lies not only in its silicon manufacturing but also in its advanced packaging technologies. Companies can design 2D, 2.5D, and 3D building blocks with silicon using Intel’s EMIB, EMIB-T, and EMIB-M variants, which can stack multiple chiplets and combine numerous HBM memory modules into a single package. Intel has even demonstrated the use of 47 tiles in a single package and envisions multi-kilowatt solutions per package. Meanwhile, TSMC’s leading packaging technology, CoWoS, reportedly struggles with four reticle-sized dies, causing some production issues for NVIDIA.